Ga₂O₃:提高栅极介电性能
2025/1/3 16:15:24 材料来源:ACT化合物半导体
HfSiOx退火膜具备形成高质量介电材料的关键属性,用于β-Ga2O3器件中的栅极介电层
为了充分发挥潜力,β-Ga2O3肖特基势垒二极管和各种类型的场效应晶体管(FET)需要一种高质量的介电材料。
美国的一个工程师团队声称满足了这一需求。这些研究人员开发了一种形成HfSiOx的过程,这种氧化物被认为结合了高介电常数和大的能带偏移,几乎可以忽略的栅极漏电流,低界面和体陷阱密度,以及大的击穿场。
关键的是,HfSiOx的击穿场高达8.7 MV/cm,明显超过了β-Ga2O3的理论击穿场8 MV/cm。通过确保介电材料具有比器件更高的击穿场,后者可以充分发挥其潜力。
在β-Ga2O3上生产高质量HfSiOx介电层的过程是由密歇根大学、联合学院和加州大学洛杉矶分校的研究人员合作开发的。这一合作建立在先前的工作基础上,涉及开发一种用于在β-Ga2O3上生产AlSiO介电层的MOCVD过程。那项早期的工作产生了一个击穿场约为7.8 MV/cm的介电层。
切换到HfSiOx所带来的击穿增加涉及不同的沉积过程。在最新的工作中,介电层是通过原子层沉积添加的,然后在退火步骤中进行,以确保在重要特性上取得显著改进。
对HfSiOx的兴趣可以追溯到多年前,早期的研究考虑将其用作基于硅和GaN的器件的介电材料。以前的工作还表明,通过调整其组成,HfSiOx的介电常数可以从3.9变化到27,HfSiOx和β-Ga2O3之间的导带不连续性可以高达2.38 eV。
美国工程师使用金属氧化物半导体电容器来研究HfSiOx介电层在β-Ga2O3上的性能。他们从具有10微米厚β-Ga2O3层的外延晶片开始,这些晶片生长在重掺杂的n型β-Ga2O3基底上,并转向原子层沉积以添加HfSiOx薄膜,HfO2与SiO2的比例大约为1:1。为了实现这一比例,两个HfO2循环,每个循环的沉积速率为1 Å/cycle,与三个SiO2循环交替进行,沉积速率为1 Å/cycle。
为了评估退火的影响,团队生产了三种类型的电容器,介电层厚度为20纳米(见图)。一类没有经过任何形式的热处理,而另外两种在氮气中分别在400°C和900°C下进行退火。
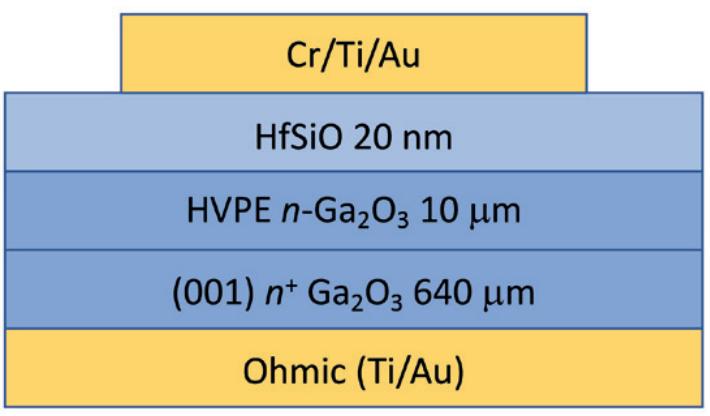 △ 金属氧化物半导体电容器用于确定HfSiOx介电层的特性。
△ 金属氧化物半导体电容器用于确定HfSiOx介电层的特性。
击穿测量确定,对于未退火的电容器,低漏电流操作发生在大约3 MV/ cm左右。与此同时,那些在400°C和900°C下退火的电容器,直到6.2 MV /cm和4.5 MV /cm才看不到漏电流,击穿场分别高达8.4 MV /cm和8.7 MV /cm。
使用发射254 nm的深紫外灯进行电容-电压测量,提供了对介电层内陷阱水平的洞察。
未退火电容器的剖面图显示,它们在低电场下未能达到累积区域。团队将这一观察归因于在体HfSiOx及其与β-Ga2O3界面处的异常高电子陷阱密度。
电容-电压测量确定了两个退火样品的总陷阱密度。团队报告了在400°C和900°C下退火的样品的平均值分别为2.72×1012 cm-2 eV-1和1.06×1012 cm-2 eV-1,表明更高的温度减少了陷阱密度。这使得团队推测,在环境氛围中900°C的退火减少了HfSiOx中的氧空位,并减少了体和界面陷阱的密度。
工程师们使用横截面扫描透射电子显微镜对他们的介电层进行了详细检查。这项技术揭示了沉积的HfSiOx中的部分有序性,900°C的退火创造了一个完全非晶态的介电层,这是降低漏电流和增加击穿电压的原因。
参考文献
X. Zhai等,Appl. Phys. Lett 124 132103 (2024)
| 上一篇:在N极性GaN上实现低接触... | 下一篇:微射流激光切割GaN晶体... |










