双势垒阳极结构实现0.36 V导通电压时10 kV击穿电压的横向GaN肖特基势垒二极管
2025/1/13 11:44:46 材料来源: ACT化合物半导体
作者:
南京大学:徐儒,陈鹏*,刘先程,陈敦军,谢自力,叶建东,修向前,张荣*,郑有炓*
南京信息工程大学:徐儒,赵见国,万发雨,常建华
江苏能华微电子科技发展有限公司:朱廷刚
通讯作者*:陈鹏 pchen@nju.edu.cn,张荣 rzhang@nju.edu.cn,郑有炓 ydzheng@nju.edu.cn
摘要:氮化镓(GaN)功率电子器件,如横向AlGaN/GaN肖特基势垒二极管(SBD),受到了重视。许多研究致力于优化器件的击穿电压(BV),特别关注实现超高电压(>10 kV)应用。然而,另一个重要问题出现了:器件能否在保持10 kV的BV的同时具有较低的开启电压(Von)?在这项研究中,我们展示了在蓝宝石基片上制备具有超过10 kV耐压的超高压AlGaN/GaN基SBD。同时,我们通过利用由铂(Pt)和钽(Ta)组成的双势垒阳极(DBA)结构,实现了非常低的0.36 V的Von。这一成就突出了GaN功率电子器件在超高压领域应用中的巨大潜力。
关键词:AlGaN/GaN肖特基二极管,双势垒阳极,开启电压,超高压
前言
AlGaN/GaN结构可以产生高电子浓度(~1×1013 cm-2)和高电子迁移率(~2000 cm2/V·s)的二维电子气(2-DEG)。结合GaN的高临界电场(~3.3 MV/cm),基于AlGaN/GaN的功率电子器件可以具有比硅基器件更快的开关速度、更低的导通电阻和更高的击穿电压。在这些器件中,功率肖特基势垒二极管(SBD)尤其重要,因为它可以满足不同场景的需求,包括高电压、高频率开关、高温和高功率密度。它们在消费电子、汽车电子、新能源、工业电机甚至超高压(>10 kV)电子领域都有广泛的潜在应用。
近年来,已经报道了大量性能优越的AlGaN/GaN SBDs,其开启电压(Von)为0.2 V至0.8 V,击穿电压(BV)为0.13 kV至10.0 kV。显然,低Von、低比导通电阻(Ron,sp)以及高BV和低漏电流(Ileakage)对于高性能的AlGaN/GaN功率SBDs 至关重要,尤其是对于低损耗和高效率的电力传输系统。然而,Von、Ileakage和BV主要由肖特基接触决定,难以同时改进这三个参数。在先前的报道中,为了实现低Von,阳极凹槽结构已被广泛使用1-8。使用低功用函数阳极金属,如钨(W)6,8,或与欧姆-肖特基组合阳极1-4,可以进一步降低Von至<0.5 V。然而,需要注意的是,这可能也对Ileakage和BV产生一些负面影响。简单采用低功用函数金属作为肖特基电极会导致一些不利影响,例如更高的Ileakage和更低的BV。如果在保持高BV的同时,使用低功用函数金属,需要一种新的电极结构设计。许多课题组已经展示了各种终端结构用以优化SBDs的Von9-12和BV13-27,包括我们先前工作中报告的带场板的2.7-kV和3.4-kV的AlGaN/GaN SBDs28,29。在我们先前的研究中,对于在Si衬底上的AlGaN/GaN SBDs,实现达到10 kV的BV仍具有挑战性30。通过使用在SiC或蓝宝石衬底上生长的高质量GaN材料,已经报道了具有大于9 kV和大于10 kV的BV的高性能AlGaN/GaN SBDs14,22,25,26,30。事实上,实现高性能AlGaN/GaN SBDs仍存在诸多挑战,因为需要合适的阳极结构以确保Von < 0.5 V,以及高质量的GaN材料以实现BV > 10 kV,研究人员目前正在积极探索这些关键因素。
在这项工作中,我们课题组提出了由高功函数的铂(Pt, 5.65 eV)和低功函数的钽(Ta, 4.25 eV)组成的双势垒阳极(DBA)结构。我们创新地结合了这两种金属的特性,并将它们排列成了交替的齿状图案。当将它们用作阳极时,开启电压Von将由具有低功函数的金属钽确定,而漏电流Ileakage和击穿电压BV将主要受到具有高功函数的金属铂的主导。此外,在蓝宝石衬底上生长高质量的碳掺杂GaN缓冲层,我们成功地制备了具有低Von、低Ileakage和超高BV的AlGaN/GaN SBD,并展示了其在低损耗和高效率电力传输系统中的潜力。
器件设计和制备
样品是通过金属有机化学气相沉积生长在一个2英寸的c面蓝宝石衬底上。从衬底开始,器件结构包括一个成核层,一个3μm的碳掺杂GaN缓冲层,一个200 nm的i-GaN沟道层,一个1 nm的AlN间隔层,一个20 nm的Al0.25Ga0.75N势垒层,一个2 nm的GaN盖层和一个50 nm的原位SiNx层。
详细的制备过程见制备方法一节,一些工艺参数和主要结果已在我们先前的工作中报告28-30。
为了在保持器件的反向特性的同时实现低Von,我们设计了一种与我们先前工作中不同的新器件结构。已知SBD的Von和Ileakage由肖特基势垒决定。显然,阳极金属的功函数起着至关重要的作用。一种可能的方法是通过低功函数金属实现低Von,同时结合使用高功函数金属获得低Ileakage和高BV。因此,在这项工作中,提出了一种双势垒结构的SBD结构。图1展示了器件的横截面示意图;阳极由两种金属(Ta和Pt)组成。Ta电极呈锯齿形状,覆盖着Pt电极。Ta电极设计成圆形排列,以防止过早受损。本工作中的所有SBD器件均具有半径为90μm的圆形阳极和阳极-阴极间距(LAC)为85μm。超出阳极凹口的电极传输长度(LT)为3μm。每个锯齿状Ta阳极的宽度为10μm,它们之间的夹角(AngleTa)范围从11.25度到30度。值得注意的是,我们的器件没有任何场板或其他终端结构,用以体现GaN材料的本身优势。
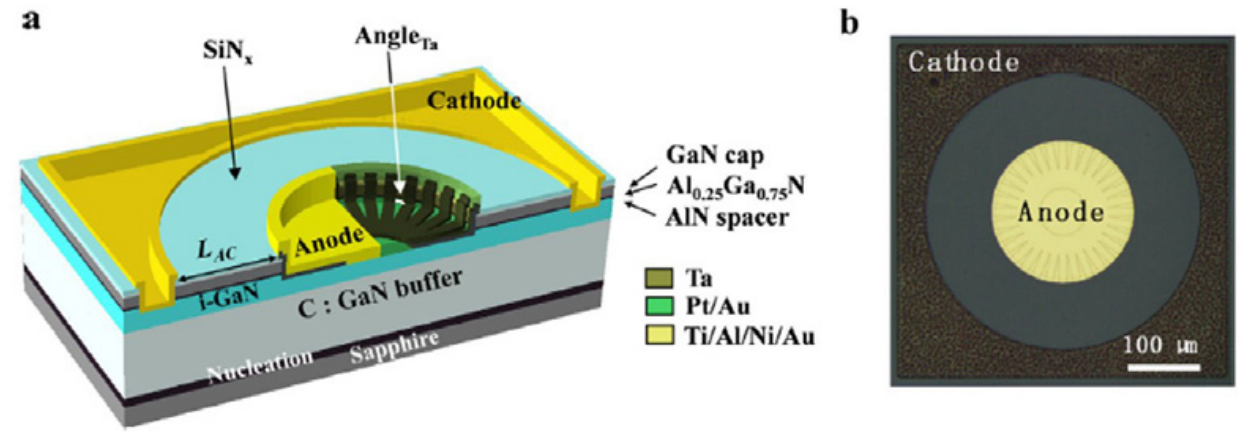 △ 图1:器件结构。(a)蓝宝石衬底上具有双势垒阳极(DBA)结构的AlGaN/GaN横向SBD的示意横截面图。(b)制备的具有85μm的LAC和180μm直径阳极的DBA SBD的顶视照片。
△ 图1:器件结构。(a)蓝宝石衬底上具有双势垒阳极(DBA)结构的AlGaN/GaN横向SBD的示意横截面图。(b)制备的具有85μm的LAC和180μm直径阳极的DBA SBD的顶视照片。
室温正向和反向I-V特性
图2a和b显示了具有不同阳极结构的SBD的正向和反向I-V特性,包括DBA结构(AngleTa = 11.25度,这是一个优化的角度,将在后面的图3中讨论)和具有单金属Pt或Ta的传统阳极结构。从图2a和b中提取的具体性能已经在表1中呈现。本文侧重于GaN材料的本身特性,因此BV是基于物理击穿确定的。Von被定义为正向电流为1 mA/mm时的电压,Ron,sp是在考虑总电极延伸长度的3μm传输长度(LT)下计算的,Ileakage被提取在-5.0 kV。如表1所示,正向特性表明,DBA器件和Ta阳极器件的Von值分别为0.36 V(在1 mA/mm时),几乎是Pt阳极器件(在1 mA/mm时为0.71 V)的一半。如图2c、d所示,为了评估器件性能的一致性,我们对40个DBA SBD进行了测试并分析了结果。Von分布范围为0.35 V至0.42 V,平均值为0.37 V,主导值为0.36 V。在正向电流为100 A/cm2时的工作电压约为3.7 V。
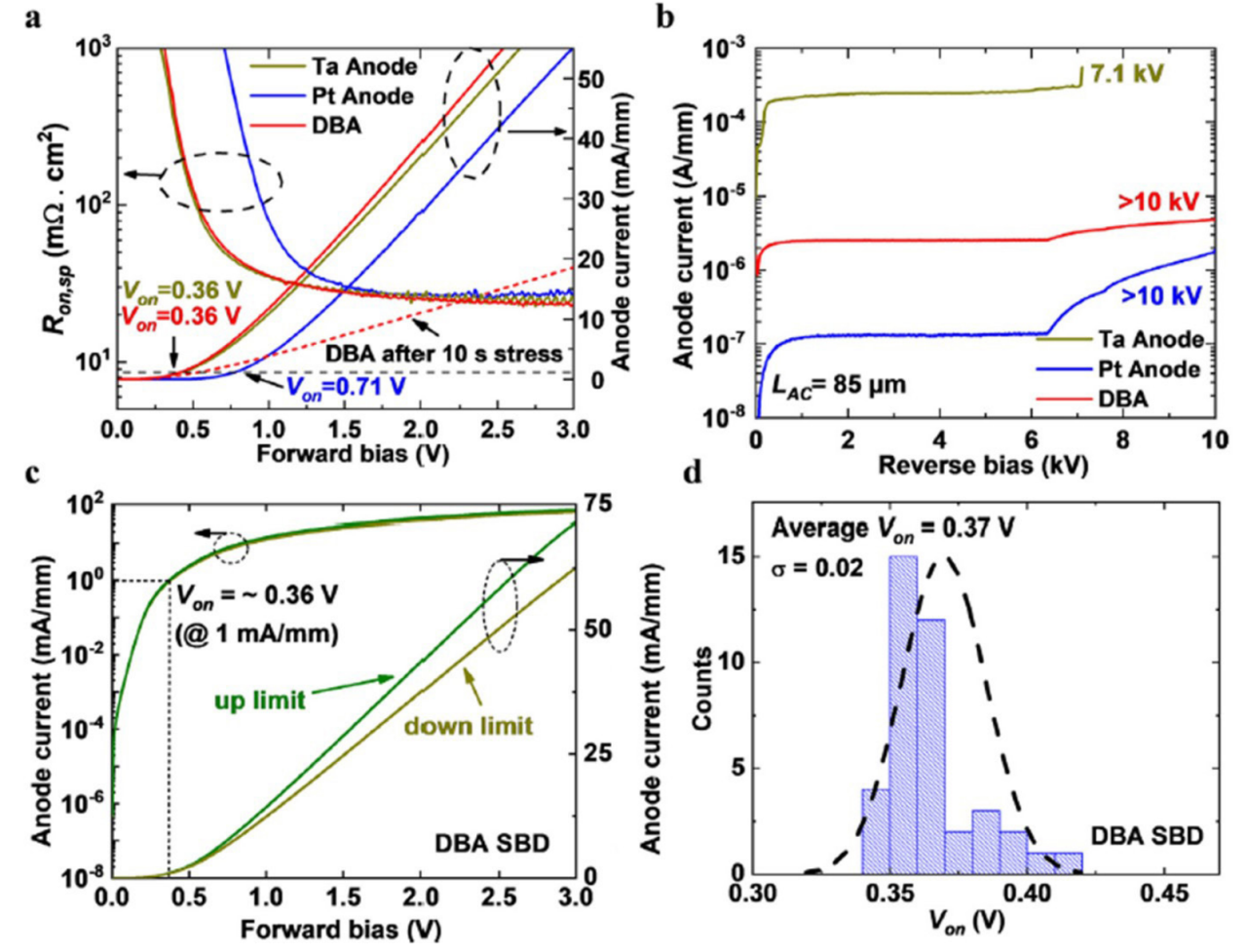 △ 图2:制备的SBD的I-V特性图。(a)具有不同阳极结构的SBD的正向I-V特性。(b)反向I-V特性。(c)40个DBA SBD器件的正向I-V特性。(d)开启电压分布(LAC=85μm)。
△ 图2:制备的SBD的I-V特性图。(a)具有不同阳极结构的SBD的正向I-V特性。(b)反向I-V特性。(c)40个DBA SBD器件的正向I-V特性。(d)开启电压分布(LAC=85μm)。
表1:具有不同阳极结构的SBD的关键性能比较。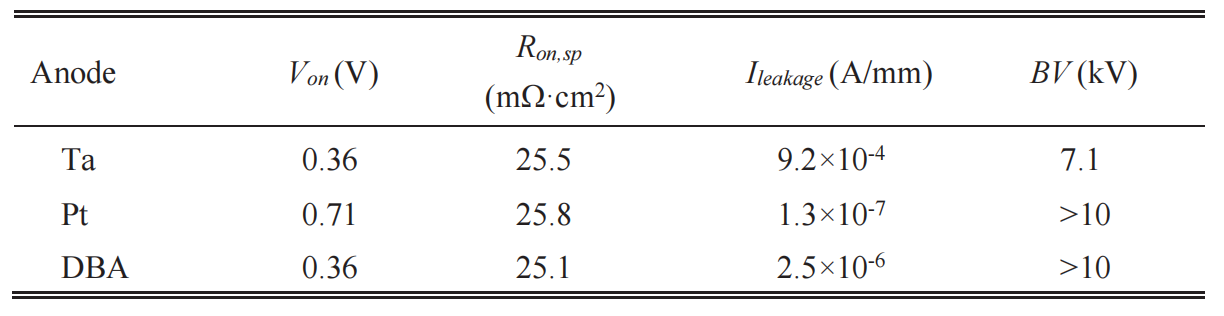
对于图2a中的三个器件,得到了约为29 Ω·mm的Ron。通过计算Ron,sp = Ron×(LAC+LT),可以发现Ron,sp在三个器件之间只有很小的差异,范围从25.1到25.8 mΩ·cm2不等。对于反向特性,DBA器件的Ileakage为2.5×10-6 A/mm,比铂阳极器件高一个数量级,但比钽阳极器件低两个数量级。BV对于DBA和铂阳极器件可以达到10 kV以上,但对于钽阳极器件仅为7.1 kV。对于超过五个DBA SBD进行了测量,BV值全部高于10 kV。DBA器件具有类似于钽阳极器件的小Von,类似于铂阳极器件的10 kV的BV,说明了DBA设计中结合了钽和铂的优点。为了检验器件的稳定性,在高电压压力之后测量了Von和Ron。当SBD在高反向电压(-8 kV)压力下进行了10 s后立即打开时,Von从0.36 V增加到0.49 V,Ron,sp从25.1 mΩ·cm2增加到95.1 mΩ·cm2,如图2a中所示的红色虚线所示。然而,这种退化不是永久性的,并且可以在短时间内(几分钟内)在正常连续前向电压下完全恢复。需要进一步优化器件结构。为了抑制这种退化,需要制造出高质量的结构,不仅减少表面和界面的陷阱密度,还需要尽量减少晶体内的缺陷密度。
可以看出,钽电极的作用非常重要,因此有必要研究DBA中钽的比例。我们制备了具有不同钽电极比例的DBA SBD器件,钽电极之间的角度(AngleTa)范围从0°(完全钽阳极)到90°(完全铂阳极)。图3a显示了具有不同AngleTa的器件的正向I-V特性,图3b中提取了Von和Ron,sp。随着AngleTa的增加,器件的Von逐渐从0.36 V增加到0.65 V,直到完全铂阳极SBD的0.71 V。Ron,sp显示出小幅波动,通常接近26 mΩ·cm2。此外,如图3a所示,在所有三个正向I-V曲线中都存在明显的转折点,之后电流呈更快速度增加。造成这种现象的主要原因是铂和钽电极的功函数差异,将在器件模拟部分详细阐述。根据这些实验结果,带有优化AngleTa=11.25°的DBA器件性能最好。
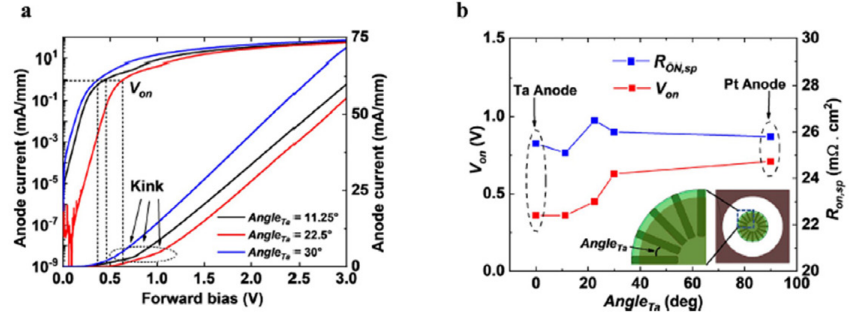 △ 图3:具有不同AngleTa的DBA SBD的正向I-V特性。(a)具有不同AngleTa的DBA SBD的正向I-V特性。(b)从AngleTa变化提取的Von和Ron,sp。(插图:DBA SBD的布局)
△ 图3:具有不同AngleTa的DBA SBD的正向I-V特性。(a)具有不同AngleTa的DBA SBD的正向I-V特性。(b)从AngleTa变化提取的Von和Ron,sp。(插图:DBA SBD的布局)
根据以上实验结果,对于优化后的DBA器件(AngleTa=11.25°),计算得到功率优良指数(P-FOM=BV2/Ron,sp)为4.0 GW/cm2。这些性能表明,DBA结构可以在保持低Ileakage和高BV的同时有效地降低器件的Von。
器件模拟
为了揭示优化的DBA结构工作的具体机制,使用Silvaco软件进行了一系列3D模拟研究,如图4所示。在模拟中,将阳极设置为与金属Pt和Ta结合的DBA结构,反映了实际器件。Ta被以齿形集成在周围的Pt中。图4显示了在不同电压条件下SBD的电场分布。切面来自AlGaN/GaN界面。在这里我们使用VAC代表阳极-阴极电压,Von.Ta代表Ta阳极的Von,Von.Pt代表Pt阳极的Von。从表1中,Von.Ta和Von.Pt的值分别为0.36V和0.71V。
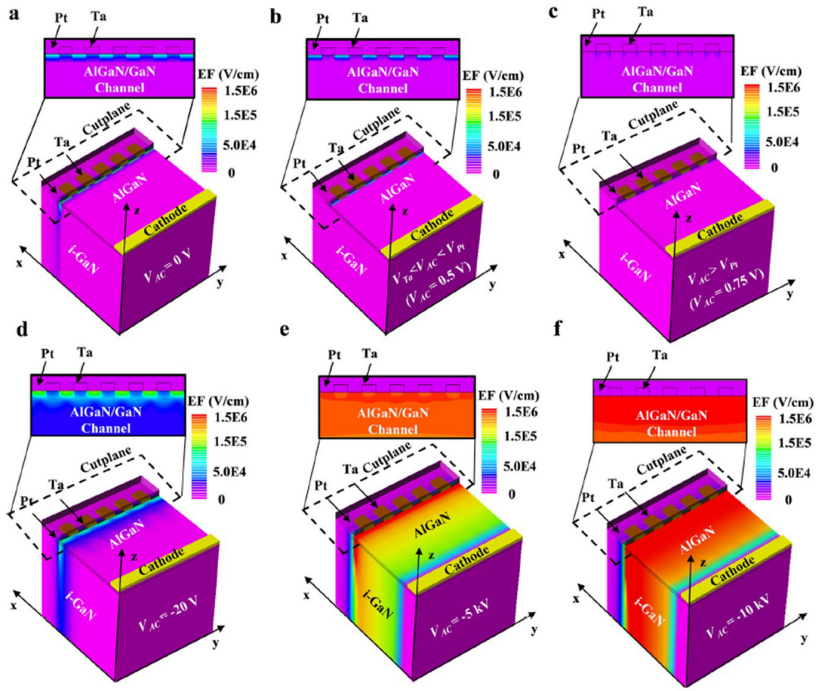 △ 图4:在不同阳极-阴极电压下模拟的DBA结构器件的电场分布。(a)VAC=0 V。(b)Von.Ta<VAC<Von.Pt (VAC=0.5 V)。(c)VAC>Von.Pt (VAC=0.75 V)。(d)VAC= -20 V。(e)VAC= -5 kV。(f)VAC= -10 kV。
△ 图4:在不同阳极-阴极电压下模拟的DBA结构器件的电场分布。(a)VAC=0 V。(b)Von.Ta<VAC<Von.Pt (VAC=0.5 V)。(c)VAC>Von.Pt (VAC=0.75 V)。(d)VAC= -20 V。(e)VAC= -5 kV。(f)VAC= -10 kV。
对于n型肖特基接触,在理想条件下,耗尽区宽度Wd可以表示为31:
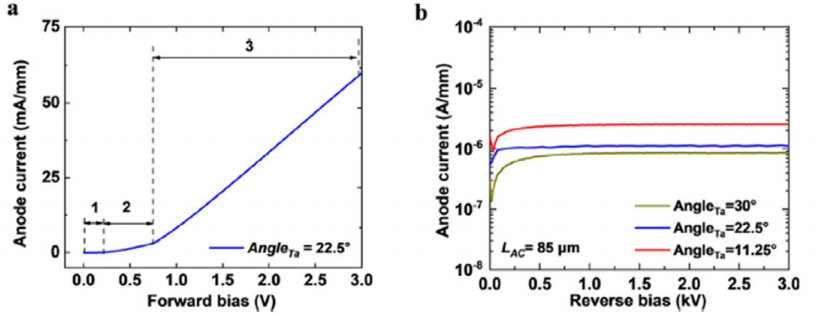 △ 图5:一种DBA SBDs的I-V曲线。(a)具有AngleTa=22.5°的DBA SBD的正向I-V曲线。(b)不同AngleTa的DBA SBD的反向I-V曲线。
△ 图5:一种DBA SBDs的I-V曲线。(a)具有AngleTa=22.5°的DBA SBD的正向I-V曲线。(b)不同AngleTa的DBA SBD的反向I-V曲线。
在图5中,我们将正向I-V曲线分为三个部分。在第1部分中,器件未被开启。此时,如图4a所示,由Pt和Ta形成的耗尽区覆盖了阳极下的整个区域。在第2部分中,当Von.Ta<VAC<Von.Pt时,如图4b所示,Ta下的耗尽区几乎消失了。尽管在此阶段Pt下的耗尽区仍然存在,但电子可以通过Ta下的通道通过转到SBD,这表明SBD的Von主要由Ta确定。同样,随着Ta的比例减少(相当于AngleTa增加),Pt的影响变得更为显着,导致图3b所示的现象。一旦AngleTa达到30度,器件的Von几乎表现出Pt的特征。在第3部分中,当VAC>Von.Pt时(即VAC=0.75V),如图4c所示,Pt下的耗尽区开始消失。在这个阶段,整个电极下的总体耗尽区几乎消失,使得电子可以在Ta和Pt电极下流动。因此,正向电流由两部分组成,这解释了为什么DBA器件在正向I-V特性中出现了棱角。
当VAC<0 V时,如图4d所示,由相邻的Pt形成的耗尽区逐渐扩大直至连接,导致在小的反向电压-20 V下出现连续的耗尽区。当施加-5 kV和-10 kV的大反向偏压时,如图4e和f所示,整个耗尽区统一且完全连接,Pt几乎主导了通道的耗尽。在这个阶段,由于Ta的功函数较低,与单个Pt阳极器件相比,少量电子可以通过Ta传输并产生漏电流。随着Ta比例的增加,越多的电子将通过,如图5b所示,漏电流随Ta电极比例增加而增加。
这些结果表明,在DBA结构中,Pt主导了反向耗尽过程,从而使得DBA器件能够保持与单个Pt阳极类似的高击穿电压。同时,由于在DBA结构中Ta电极仅部分覆盖阳极,因此由Ta电极引起的漏电流相较于具有完整Ta阳极的器件也相对减少。请参考图2b,优化后的DBA器件的漏电流比单个Pt阳极器件大一个数量级,但比完整Ta阳极器件低两个数量级,这也表明在优化后的DBA器件中在反向偏压下Pt发挥了主导作用。
为了更好地反映DBA阳极的特性,我们对一个Pt阳极器件、一个Ta阳极器件和三个Pt/Ta DBA器件(具有不同的AngleTa,即每个Ta金属之间的距离不同)进行了-5kV的反向电场模拟。如图6a和6b所示,对于Pt阳极和Ta阳极器件,在-5 kV下,通道中的电场分布在剖面(横向)上是均匀的,并沿纵向逐渐减小。对于DBA器件,如图6c、d和e所示,尽管最终耗尽区都完全连接,但通道中的电场分布在剖面(横向)上并不是均匀的。这种波动反映了来自Ta排列的影响,每个Ta金属之间距离越短,电场分布的波动越小。但是,很明显,Pt主宰了耗尽区的连接。
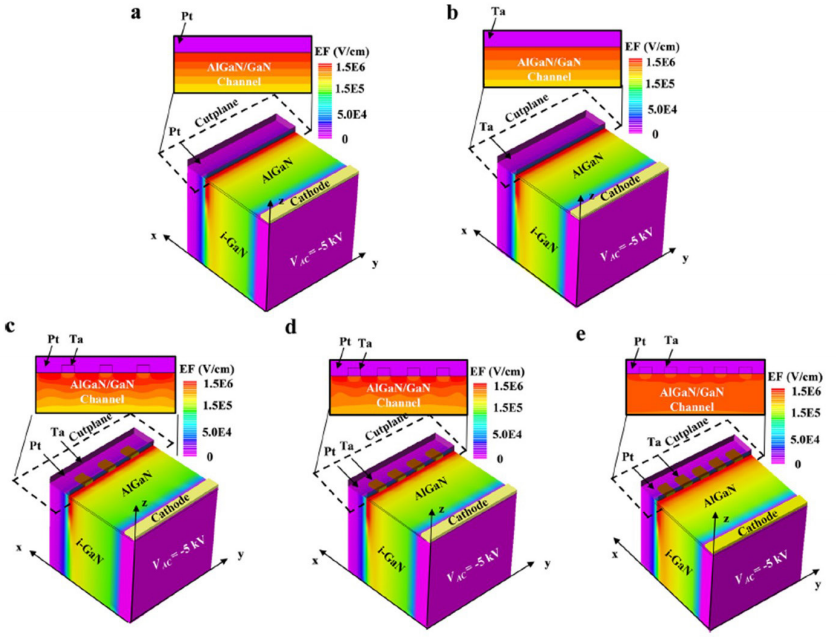 △ 图6:在-5kV下,对一个Pt阳极器件、一个Ta阳极器件以及带有不同距离的每个Ta金属(类似不同角度)的Pt/Ta DBA器件进行的模拟电场分布。(a)Pt阳极器件。(b)Ta阳极器件。(c)DBA器件AngleTa=30°。(d)DBA器件AngleTa=22.5°。(e)DBA器件AngleTa=11.25°。
△ 图6:在-5kV下,对一个Pt阳极器件、一个Ta阳极器件以及带有不同距离的每个Ta金属(类似不同角度)的Pt/Ta DBA器件进行的模拟电场分布。(a)Pt阳极器件。(b)Ta阳极器件。(c)DBA器件AngleTa=30°。(d)DBA器件AngleTa=22.5°。(e)DBA器件AngleTa=11.25°。
通过结合Ta在正向偏压下的优势和Pt在反向偏压下的优势,我们采用DBA结构实现了低Von和高BV的SBD。图7绘制了目前GaN基横向SBD的BV与Von以及Ron,sp的基准图。本研究的DBA SBD不仅在任何衬底上的GaN基横向SBD中展示了高于10 kV的高BV,而且还实现了低至0.36 V的低Von和25.1 mΩ·cm2的低Ron,sp。我们的研究表明,在SBD阳极中使用合适的金属组合和几何配置可以充分利用每种金属的特定优势,从而提高各个方面的器件性能,反映了在实现器件性能突破方面的新方法。
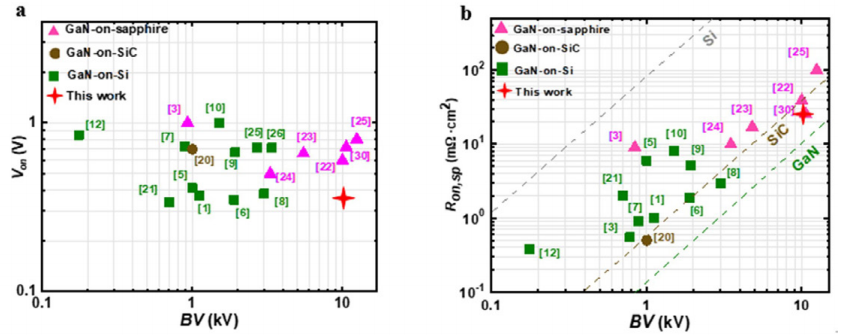 △ 图7:DBA SBD的基准图。(a)GaN横向SBD在蓝宝石/SiC/Si基板上的BV与Von的基准图。(b)GaN横向SBD在蓝宝石/SiC/Si基板上的BV与Ron,sp的基准图。
△ 图7:DBA SBD的基准图。(a)GaN横向SBD在蓝宝石/SiC/Si基板上的BV与Von的基准图。(b)GaN横向SBD在蓝宝石/SiC/Si基板上的BV与Ron,sp的基准图。
结论
总的来说,在本研究中,通过使用DBA结构和高质量的生长在蓝宝石基板上的GaN材料,我们实现了低Von和高BV的SBD器件。该DBA SBD的Von为0.36V,而BV保持在10 kV。结合Ron,sp为25.1 mΩ·cm2,器件的最高P-FOM可高达4.0 GW/cm2。这些结果证明了结合金属阳极并成功利用每种金属的优势的可行性,为实现低通态AlGaN/GaN SBD与超高击穿电压提供了可行的解决方案,有望推动GaN材料在超高压电子领域的应用。
制备方法
SBD的制作。首先,光刻定义SBD隔离区域,然后使用CF4气体通过反应离子刻蚀(RIE)对SiNx进行刻蚀,使用Cl2/BCl3混合物通过感应耦合等离子体(ICP)刻蚀出隔离台地。在第二步中,阳极凹陷区域也通过Cl2和BCl3混合物通过ICP进行刻蚀。然后,在80℃下使用稀释的KOH溶液在15分钟内对样品进行刻蚀以去除刻蚀损伤。最后一步,我们将Ta(50 nm)和Pt/Au(50/300 nm)的混合物作为阳极,呈锯齿状形状。阴极为Ti/Al/Ni/Au(30/150/30/100 nm),在N2中快速退火850℃ 30秒。还制作了具有单Pt/Au(50/300 nm)和Ta/Au(50/300 nm)阳极的SBD。
电性能测试
使用Keithley 4200测量正向IV特性。使用IWATSUCS12105C半导体曲线跟踪仪测量反向击穿电压。
致谢:作者感谢Corenergy有限公司为晶片的外延生长提供支持。本工作受到国家重点研发计划资助(批准号:2022YFE0122700)、国家高技术研究发展计划(批准号:2015AA033305)、江苏省重点研发计划(批准号:BK2015111)、中国博士后科学基金资助(批准号:2023M731583)、江苏省创新创业博士项目、国家电网山东电力公司和电力研究院的研发基金的支持。
竞争利益声明:作者声明没有竞争利益。
扩展阅读
1. H. S. Lee. et al, 0.34 VT AlGaN/GaN-on-Si large Schottky barrier diode with recessed dual anode metal, IEEE Electron Device Lett., 36, 1132–1134 (2015). https://doi.org/10.1109/LED.2015.2475178.
2. J. G. Lee. et al, Low turn-on voltage AlGaN/GaN-on-Si rectifier with gated ohmic anode, IEEE Electron Device Lett., 34, 214–216 (2013). https://doi.org/10.1109/LED.2012.2235403.
3. K. Park. et al, 1 kV AlGaN/GaN Power SBDs with Reduced On Resistances. in Proc. IEEE 23th Int. Symp. Power Semiconductor Devices IC’s, 223–22610 (2011). https://doi.org/10.1109/ISPSD.2011.5890831.
4. X.W. Kang. et al, Recess-Free AlGaN/GaN Lateral Schottky Barrier Controlled Schottky Rectifier with Low Turn-on Voltage and High Reverse Blocking, in Proc. IEEE 30th Int. Symp. Power Semiconductor Devices IC’s, 280–283 (2018). https://doi.org/10.1109/ISPSD.2018.8393657.
5. Lenci. S. et al, Au-free AlGaN/GaN power diode on 8-in Si substrate with gated edge termination, IEEE Electron Device Lett., 34, 1035–1037 (2013). https://doi.org/10.1109/LED.2013.2267933.
6. T. Zhang. et al, A 1.9-kV/2.61-mΩ · cm2 Lateral GaN Schottky Barrier Diode on Silicon Substrate With Tungsten Anode and Low Turn-ON Voltage of 0.35 V, IEEE Electron Device Lett., 39, 1548–1551 (2018). https://doi.org/10.1109/LED.2018.2864874.
7. J. C. Lei. et al, 650-V double-channel lateral Schottky barrier diode with dual-recess gated anode, IEEE Electron Device Lett., 39, 260–263 (2017). https://doi.org/10.1109/LED.2017.2783908.
8. T. Zhang. et al, A > 3 kV/2.94 mΩ · cm2 and Low Leakage Current With Low Turn-On Voltage Lateral GaN Schottky Barrier Diode on Silicon Substrate With Anode Engineering Technique, IEEE Electron Device Lett. 40, 1583-1586 (2019). https://doi.org/10.1109/LED.2019.2933314.
9. Ma, J., Kampitsis, G., Xiang, P., Cheng, K. & Matioli, E. Multi-Channel tri-gate GaN power Schottky diodes with low ON-resistance. IEEE Electron Device Lett. 40, 275–278 (2019). doi: https://doi.org/10.1109/LED.2018.2887199.
10. Zhou , Q. et al. High reverse blocking and low onset voltage AlGaN/GaN-on-Si lateral power diode with MIS-gated hybrid anode. IEEE Electron Device Lett. 36, 660–662 (2015). doi: https://doi.org/10.1109/LED.2015.2432171.
11. Bahat-Treidel, E. et al. Fast-switching GaN-based lateral power Schottky barrier diodes with low onset voltage and strong reverse blocking. IEEE Electron Device Lett. 33, 357–359 (2012). doi: https://doi.org/10.1109/LED.2011.2179281.
12. Basler, M. et al. Large-area lateral AlGaN/GaN-on-Si field-effect rectifier with low turn-on voltage. IEEE Electron Device Lett. 41, 993–996 (2020). doi: https://doi.org/10.1109/LED.2020.2994656.
13. Zhu, M. et al. 1.9-kV AlGaN/GaN lateral Schottky barrier diodes on silicon. IEEE Electron Device Lett. 36, 375–377 (2015). doi: https://doi.org/10.1109/LED.2015.2404309.
14. Colón A. et al. Demonstration of a 9 kV reverse breakdown and 59 mΩ-cm2 specific on-resistance AlGaN/GaN Schottky barrier diode. Solid-state Electronics. 151, 47–51 (2019). doi: https://doi.org/10.1016/j.sse.2018.10.009.
15. Lian, Y.-W., Lin, Y.-S., Yang, J.-M. Cheng, C.-H. & Hsu, S. S. H. AlGaN/GaN Schottky barrier diodes on silicon substrates with selective Si diffusion for low onset voltage and high reverse blocking. IEEE Electron Device Lett. 34, 981–983 (2013). doi: https://doi.org/10.1109/LED.2013.2269475.
16. Matioli, E., Lu, B. & Palacios, T. Ultralow leakage current AlGaN/GaN Schottky diodes with 3-D anode structure. IEEE Trans. Electron Devices. 60, 3365–3370 (2013). doi: https://doi.org/10.1109/TED.2013.2279120.
17. Zhang A.P. et al. Lateral AlxGa1-xN power rectifiers with 9.7 kV reverse breakdown voltage. Applied Physics Letters. 78, 823–825 (2001). doi: https://doi.org/10.1063/1.1346622.
18. Tsou, C.-W., Wei, K.-P., Lian, Y.-W. & Hsu, S. S. H. 2.07-kV AlGaN/GaN Schottky barrier diodes on silicon with high Baliga’s figure-of-merit. IEEE Electron Device Lett. 37, 70–73 (2016) doi: https://doi.org/10.1109/LED.2015.2499267.
19. Kamada, A., Matsubayashi, K., Nakagawa, A., Terada, Y. & Egawa, T. High-voltage AlGaN/GaN Schottky barrier diodes on Si substrate with low-temperature GaN cap layer for edge termination. In 2008 20th International Symposium on Power Semiconductor Devices and IC's, 225-228. (IEEE 2008). doi: https://doi.org/10.1109/ISPSD.2008.4538939.
20. Lee , S.-C. et al. High breakdown voltage GaN Schottky barrier diode employing floating metal rings on AlGaN/GaN heterojunction. In 2005 Proceedings. ISPSD '05. The 17th International Symposium on Power Semiconductor Devices and ICs, 247-250. (IEEE 2005). doi: https://doi.org/10.1109/ISPSD.2005.1487997.
21. Lee , G.-Y., Liu, H.-H. & Chyi, J.-I. High-performance AlGaN/GaN Schottky diodes with an AlGaN/AlN buffer layer. IEEE Electron Device Lett. 32, 1519–1521 (2011). doi: https://doi.org/10.1109/LED.2011.2164610.
22.M. Xiao. et al, 10 kV, 39 mΩ · cm2 Multi-Channel AlGaN/GaN Schottky Barrier Diodes, IEEE Electronics Letters, 42, 808-811 (2021). https://doi.org/10.1109/LED.2021.3076802.
23. M. Xiao. et al, 5 kV Multi-Channel AlGaN/GaN Power Schottky Barrier Diodes with Junction-Fin-Anode, in IEEE international Electron Devices Meeting, 2020. https://doi.org/10.1109/IEDM13553.2020.9372025.
24. M. Xiao. et al, 3.3 kV Multi-Channel AlGaN/GaN Schottky Barrier Diodes With P-GaN Termination, IEEE Electron Device Lett., 41, 1177-1180 (2020). https://doi.org/10.1109/LED.2020.3005934.
25. S. W. Han. et al, 12.5 kV GaN Super-Heterojunction Schottky Barrier Diodes, IEEE Transactions on Electron Devices, 68, 5736-5741 (2021). https://doi.org/10.1109/TED.2021.3111543.
26. S. W. Han. et al, GaN super-heterojunction Schottky barrier diode with over 10 kV blocking voltage, in Proc. 5th IEEE Electron Devices Technol. Manuf. Conf.,1–3 (2021). https://doi.org/10.1109/EDTM50988.2021.9420906.
27. S. W. Han. et al, Experimental demonstration of charge-balanced GaN super-heterojunction Schottky barrier diode capable of 2.8 kV switching, IEEE Electron Device Lett., 41, 1758–1761 (2020). https://doi.org/10.1109/LED.2020.3029619.
28. R. Xu. et.al, 2.7-kV AlGaN/GaN Schottky barrier diode on silicon substrate with recessed-anode structure, Solid State Electronics, 175, 107953 (2021). https://doi.org/10.1016/j.sse.2020.107953.
29. R. Xu. et.al, 3.4-kV AlGaN/GaN Schottky barrier diode on silicon substrate with engineered anode structure, IEEE Electron Device Lett, 42, 208-211 (2021). https://doi.org/10.1109/LED.2020.3049086.
30. R. Xu. et al, High power Figure-of-Merit, 10.6-kV AlGaN/GaN lateral Schottky barrier diode with single channel and sub-100-μm anode-to-cathode spacing, Small, 18, 2270199 (2022). https://doi.org/10.1002/smll.202107301.
31. S. M. Sze, M. K. Lee, Semiconductor Devices: Physics and Technology, (Wiley, 2012).
| 上一篇:如何整合硅和III-V族 | 下一篇:扩展5G和6G的III-V技术... |










